Neil Massey,安世半导体国际产品营销经理
汽车和工业应用都需要不断提高功率密度。例如,为了提高安全性,新的汽车动力转向设计现在要求双冗余电路,这意味着要在相同空间内容纳双倍的元器件。再举一个例子,在服务器群中,每平方米都要耗费一定成本,用户通常每18个月要求相同电源封装中的输出功率翻倍。如果分立式半导体供应商要应对这一挑战,不能仅专注于改进晶圆技术,还必须努力提升封装性能。
总部位于荷兰的安世半导体是分立器件、MOSFET器件、模拟和逻辑集成电路领域的领导者,该公司率先在-功率封装(LFPAK无损封装)内部采用了全铜夹片芯片贴装技术,目的是实现多种技术优势(电流能力、RDSon、热特性等)。
LFPAK封装系列用于提高功率密度。其主要特点是在封装内部使用了全铜夹片,在外部使用了鸥翼引脚。安世半导体在2002年率先推出LFPAK56封装 - 它是一款功率SO8封装(5mm x 6mm),设计用于替代体积更大的DPAK封装。现在,该公司提供了一系列不同尺寸的封装,包含单双通道MOSFET配置,可涵盖众多不同应用。最近,安世半导体发布了LFPAK88,这是一款8mm x 8mm封装,针对较高功率的应用而设计,可取代体积更大的D²PAK和D²PAK-7封装。
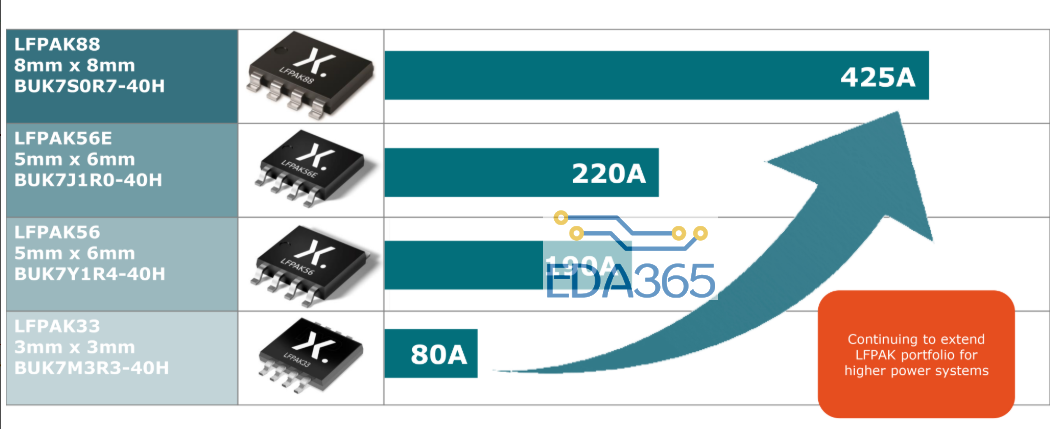
图1:LFPAK分立式MOSFET封装系列
LFPAK器件的体积小于老式D²PAK和D²PAK-7器件,同时实现了功率密度的明显提升。
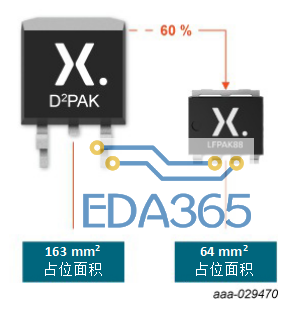
图2:LFPAK88的占位面积小于D²PAK
上图显示了LFPAK88的相对占位面积大小,与D²PAK器件相比减小了60%;另外LFPAK88器件的高度更低,因而总体积减小了86%。
LFPAK88之所以能够实现性能和功率密度的提升,是因为它采用了铜夹片封装技术,取代了D²PAK和D²PAK7等封装采用的老式焊线技术。

图3:与使用焊线连接的D²PAK与使用铜夹片技术的LFPAK88
铜夹片技术的性能优势包括:
1.电流(Amp)
·焊线是一个制约因素,它决定了器件能够处理的电流大小。在使用D²PAK封装的情况下,使用的焊线的最大直径为500µm(由于连接的T型柱尺寸)。
·使用最新Trench 9超级结40V晶圆,安世半导体能够放入D²PAK封装的最大晶圆电流额定值为120A。但是,对于体积更小的LFPAK88封装,由于不受焊线制约,安世半导体目前能够放入该封装的最大晶圆电流额定值为425A。随着公司以后发布更大晶圆的产品,此电流额定值还会提高。[注:这些值来自于测量而并非理论]
2.RDS(on) [以mΩ为单位]
·在D²PAK中使用的三条500µm直径的焊线增加了MOSFET的总RDS(on)值。
·例如,在上述两个器件中使用相同的Trench 9 40V技术平台,安世半导体目前能够放入D²PAK的最大晶圆的RDS(on)值为1.2m?6?8。如果使用体积更小的夹片粘合LFPAK88封装,该值可减少至 0.7m?6?8,这要归功于它没有焊线电阻。[注:0.55m?6?8的LFPAK88器件正在T9平台上开发]。
3.寄生源极电感 (nH)
·在每个开关事件中,必须解决寄生源极电感问题,因为它会降低效率。在需要高频率开关的应用中,例如在DC/DC转换器中,这种效率损失会产生很大影响。
源极焊线还会增加总寄生源极电感,再加上D²PAK的长引脚,电感值达到5nH。相比之下,由于LFPAK88没有源极焊线,而且只使用很小的鸥翼引脚,因而电感值仅为1nH。
4.电流/热量的热点
·当高电流通过器件时,它会集中在焊线连接到晶圆的瓶颈处。这些电流热点可能导致散热/质量问题。
·使用LFPAK88,顶部的铜夹片覆盖了更大区域,因此不会产生热点。
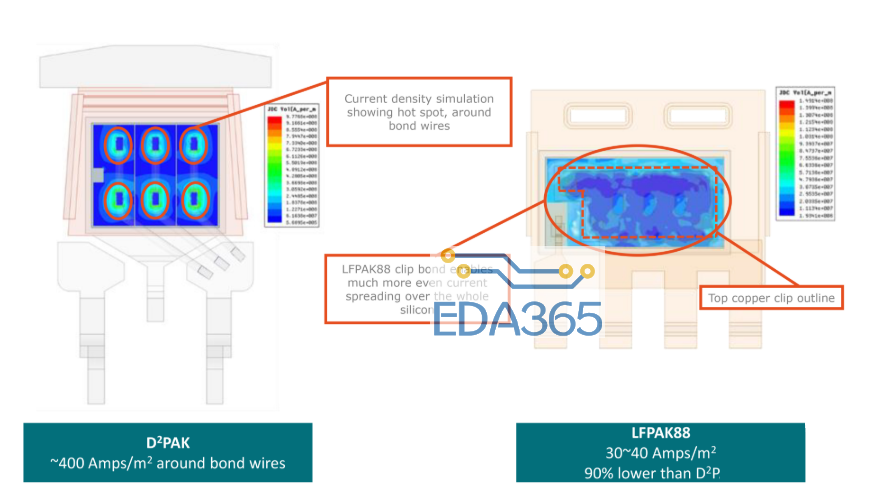
图4:D²PAK和LFPAK88的电流密度仿真以及焊线上的热点
5.热阻Rth(j-mb) (K/W)
·与老式封装相比,LFPAK88具有良好的热性能。例如,如果我们计算从晶圆到封装底部连接至印刷电路板处(从结到贴装基底)的热阻,热阻值越低越好。
·D²PAK中的最大芯片的热阻为0.43K/W;LFPAK88的热阻为0.35K/W。
·更低的热阻值主要归功于传热路线更短,漏极铜夹片更薄(LFPAK88的厚度为0.5mm,D²PAK的厚度为1.3mm)
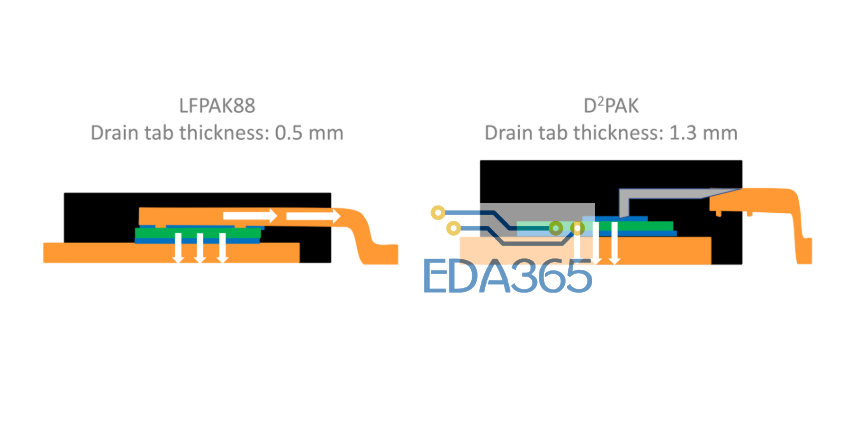
图5: LFPAK88较薄的漏极散热片和D2PAK的对比
功率密度 》1W/mm³
尺寸更小,电流能力更高,RDS(on)值更低,这些优势结合在一起,使功率密度得以提高,正如表中所总结(使用相同技术平台来提供相近的性能)
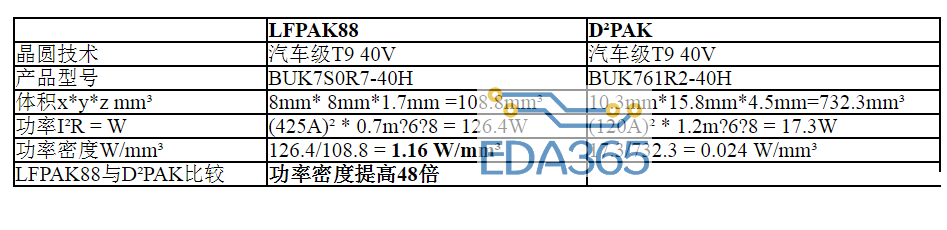
总而言之,要提高功率密度,不仅需要晶圆技术的改进,还必须利用新的封装技术,充分发挥分立式MOSFET的潜能。LFPAK全铜夹片封装系列增强了晶圆的性能表现,能够帮助我们减小占位面积,提高功率输出。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多