电容-电压(C-V)测试广泛用于测量半导体器件,尤其是MOSCAP和MOSFET结构的参数。但是,通过C-V测量还能够对很多其他类型的半导体器件和工艺进行特征分析,包括双极结型晶体管(BJT)、JFET、III-V族化合物器件、光电电池、MEMS器件、有机TFT显示器、光电二极管、碳纳米管(CNT)等。
这类测量的基本特征对于很多应用和培训都是十分有用的。大学实验室和半导体制造商通过这类测量可以评估新材料、工艺、器件和电路。C-V测量对于从事产品与良率改进工作的工程技术人员也是极其重要的,他们要负责改进工艺和器件的性能。可靠性工程师通过这类测量检验材料供应商的产品是否合格,监测工艺参数,分析器件的失效机制。
采用适当的方法、仪器和软件,我们可以测得很多半导体器件和材料的参数。从评估外延多晶的生长开始,这些信息在整个生产链中都会用到,包括平均掺杂浓度、掺杂分布、载流子寿命等参数。在圆片工艺中,通过C-V测量可以确定栅氧厚度、栅氧电荷、游离子(杂质)和界面阱密度。在另外一些工艺步骤之后还会用到这类测量,例如光刻、蚀刻、清洗、电介质与多晶硅沉积、金属化。在圆片上完成整个器件制造工艺之后,还要在可靠性与基本器件测试阶段通过C-V测量对阈值电压和其他一些参数进行特征分析,对器件的性能进行建模。
半导体电容的物理特性
MOSCAP结构是半导体制造过程中的一种基本器件形态(如图1所示)。虽然这类器件可以用于真正的电路中,但是一般将它们作为一种测试结构集成到制造工艺中。由于它们的结构简单,制造过程容易控制,因此是一种十分方便的评估底层工艺的方法。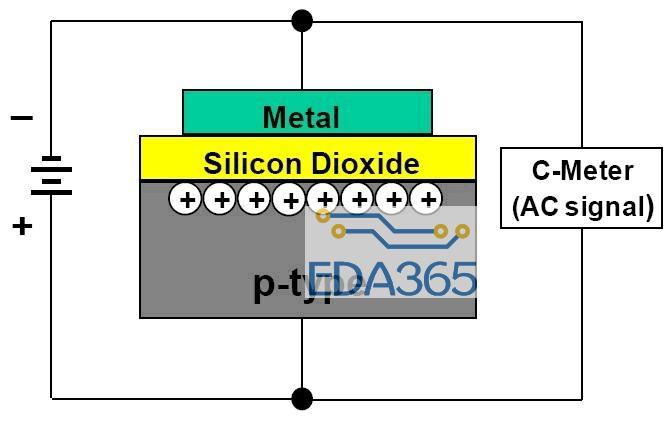
图1. 在P型衬底上构成的MOSCAP结构的C-V测量电路
图1中的金属/多晶硅层是电容的一极,二氧化硅是绝缘体。由于绝缘层下面的衬底是半导体材料,因此它本身并不是电容的另一极。实际上,多数电荷载流子是电容的另一极。从物理上来看,电容C取决于下列公式中的各个变量:
C = A (κ/d),其中
A是电容的面积, κ是绝缘体的介电常数, d是电容两极之间的间距。
因此,参数A 和κ越大,绝缘体的厚度越薄,电容的值就越大。一般而言,半导体电容值的量级为纳法到皮法,或者更小。
进行C-V测量时,通常在电容两端施加直流偏压,同时利用一个交流信号进行测量(如图1所示)。一般地,这类测量中使用的交流信号频率在10KHz到10MHz之间。所加载的直流偏压用作直流电压扫描,驱动MOSCAP结构从累积区进入耗尽区,然后进入反型区(如图2所示)。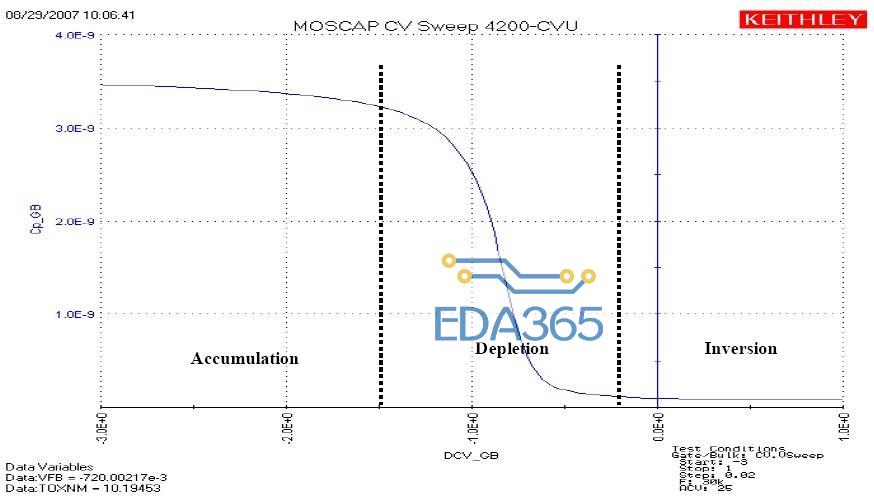
图2. 在C-V测试中获取的MOSCAP结构直流偏压扫描结果
较强的直流偏压会导致衬底中的多数载流子聚积在绝缘层的界面附近。由于它们无法穿越绝缘层,因此随着电荷在界面附近不断聚积,累积区中的电容达到最大值(即参数d达到最小值)。如图1所示。从C-V累积测量中可以得到的一个基本参数是二氧化硅的厚度tox。
随着偏压的降低,多数载流子被从栅氧界面上排斥走,从而形成了耗尽区。当偏压反相时,电荷载流子偏离氧化层的距离最大,电容达到最小值(即d达到最大值)。根据这一反型区电容,我们可以确定多数载流子的数量。MOSFET晶体管也具有类似的基本原理,只是它们的物理结构和掺杂情况更加复杂。
在将直流偏压扫过图2中三个区的过程中,我们还可以得到很多其他参数。采用不同的交流信号频率可以反映更多的详细信息。低频测试可以反映所谓的准静态特征,而高频测试则可以表征晶体管的动态性能。这两类C-V测试都是经常会用到的。


 APP下载
APP下载 登录
登录















 热门文章
热门文章