半导体芯片的结构:
汽车工业作为半导体行业的客户之一, 约占整个半导体产品5-10%的销售额, 虽然份额不大,但产品要求较高,行业内称为“车规级”半导体,比如芯片工作温度在 -40度 至 + 120度,机械振动环境20 至 30倍的地心加速度。随着新能源汽车市场的不断增长,车用电池管理系统、电机驱动等都增加了对微处理器(MCU)、 片上系统(SoC)以及功率半导体绝缘栅双极型晶体管IGBT的需求。
为了深入了解半导体芯片的结构及其成本,作为车企,我们对某个自动变速箱信号处理特种芯片(ASIC)做了一个半导体芯片探测的实验机构(见图1),在3D伦琴射线计算机断层探测下,可以比较清晰的看到这个特种芯片的内部结构(见图2),芯片的真实尺寸约一个指甲盖大小。探测的结果:
1.芯片结构宽度:0.13微米(130纳米)
2.裸芯片的面积:7.9 X 8.0毫米
3.芯片链接点:100
4.导电框尺寸(leadframe):9.0 X 9.0毫米
并可以清晰地看到裸芯片与外部端子的超声波焊接上连接结构。

图1 半导体芯片的3D X-Ray 计算机断层分析仪(载体可以360度旋转)
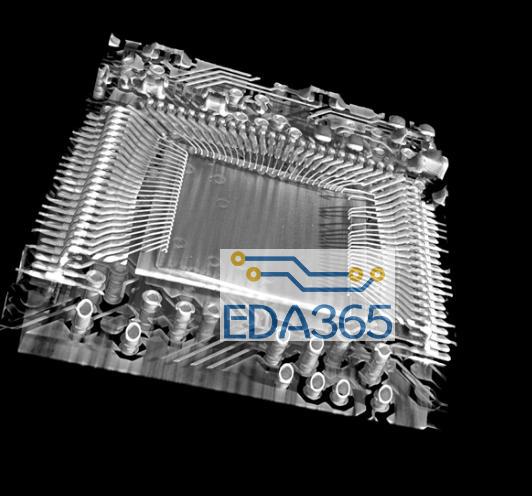
图2 在3D伦琴射线CT下探测的某个自动变速箱控制模块的信号处理特种芯片(ASIC)
此外,电子显微镜(微聚焦)对这个芯片做了断面图像分析:

图3电子显微镜下某个自动变速箱控制模块的信号处理特种芯片(ASIC)断面的成像
这样,可以探测出这颗芯片的复杂分层结构。
大多数半导体芯片多以高纯度的单晶硅作为原材料,如图4所示:

图4 高纯度单晶硅切割成的不同直径的晶圆(200、300、450毫米)
硅材料在常温下仅有微小的电导率,通过嵌入磷、硼、砷等原子,硅材料形成N、或者P极区域,N和P极边界,产生出可单向通电流的元件,这就是二极管。依此基本原理,就可以设计出三极管了(见图5)。

图5 一个双极型三极管原理示意图(英飞凌集团出版社“半导体技术及其参数”)
半导体芯片主要分为两大类,一类是双极型(bipolar),另一类是金属氧化型MOS(metal –oxide-semiconductor)。由于MOS型三极管需要的区域极其微小,能耗很小,所以它广泛应用于大规模集成电路(VLSI,集成1百万个三极管以上)
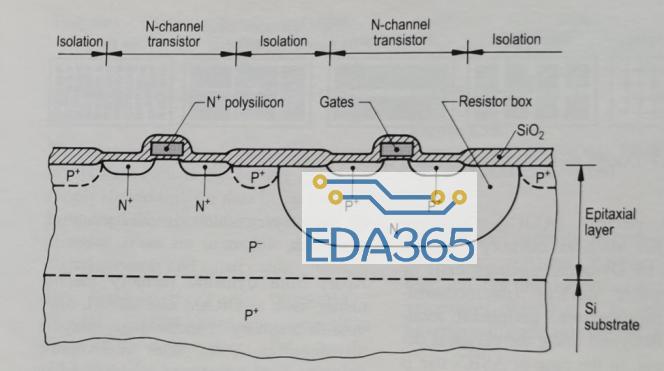
图6 一个MOS三极管示意图(英飞凌集团出版社“半导体技术及其参数”)
对比一个目前汽车域控制器的片上系统(SoC),一个芯片集成了数十亿甚至百亿个三极管。
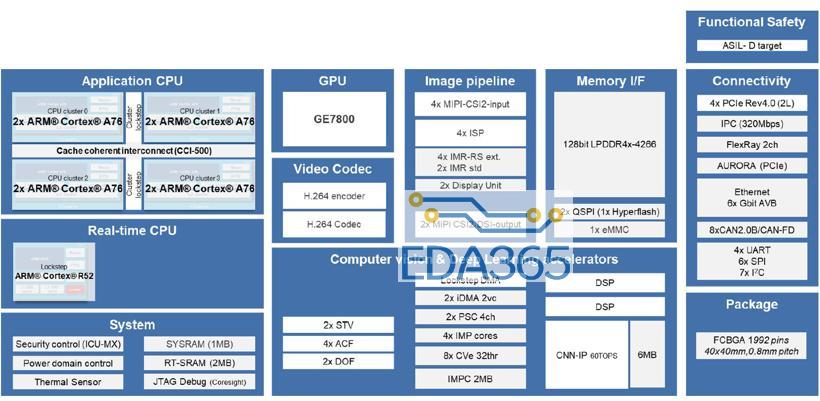
图7 一个汽车域控制器主芯片SoC的功能图(Renesas Datasheet)
这个SoC由4颗ARM Cortex A76应用核、一颗实时核ARM Cortex R52、一颗图像处理核GPU、多颗DSP(digital signal processor: 数字信号处理器)组成的计算机图形识别和深度学习加速器、多种接口(包括以太网)、安全控制、内存等模块。
半导体芯片种类(不保证完全):
1.中央处理:
1)微处理器(microcontroller: MCU)
2)图像处理器(graphic processing unit: GPU)
3)AI处理器(比如: 神经元处理单元neuronal network processing unit NPU,深度学习加速器deep learning accelerator, 张量处理单元tensor processing unit)
4)片上系统(System on chip: SoC, 集成多核微处理器、图像处理器、数字信号处理器DSP、AI处理器等的综合芯片)
2.驱动:
1)功率MOS
2)绝缘栅双极型晶体管IGBT
3.储存:
1)DRAM
2)EPROM
3)FLASH 等
4.特种芯片
1)FPGA
2)ASIC
5.传感器:
1)加速度、速度、位置
2)温度、湿度、压力
3)电流、电压
4)各种气体成分等
6.高频:
1)雷达
2)移动通信
7.光电
1)LED
2)光纤通信
这些比较复杂的芯片(集成电路)怎样设计呢?
半导体芯片设计
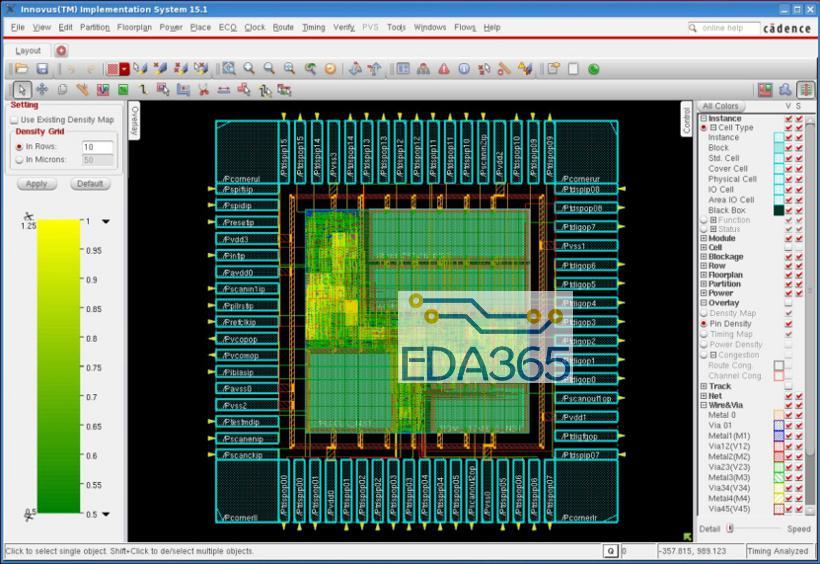
图8 集成电路设计工具(EDA)(14纳米芯片设计, EDA工具:innovus cadence)
大规模集成电路(VSLI)的设计主要分为如下步骤:
1.设计(Design),包含方案、逻辑设计、物理设计等
2.仿真(Simulation)
3.分析和验证(Analysis & Verification),包括功能、逻辑、时间、物理等科目
4.制造准备(Manufacturing Preparation)
5.功能安全(Functional Safety)
以华为海思的麒麟9000片上系统SoC为例(见图9):
集成了8颗ARM Cortex核,一枚24核的图像处理器GPU,AI达芬奇处理器,5G基带,采用5纳米结构宽度,是一个目前较为先进的SoC,集成了共约153亿个三极管,用于5G移动通信。

图9 海思的片上系统SoC麒麟9000基本参数表(海思官网)
作者建议:
从华为海思的SoC麒麟9000系列芯片可以看出,中国具有设计先进的、大规模集成电路(集成百亿个三极管的半导体芯片)的技术能力!设计这样的芯片,需要资深的技术力量、经验和一丝不苟的精神,在中国数千家半导体企业里,没有必要每家都独立设计复杂的大规模集成电路,可以用两种方式实现:
1.让数家有良好芯片设计能力和经验的企业外包设计,比如请海思来设计,这样可以集中力量办大事,为中国半导体芯片行业冲破枷锁之一(大规模集成电路的设计);
2.部分制造能力强的半导体企业成为专注半导体制造的企业,例如像台积电一样,不设独立的芯片设计部门。
半导体芯片制造
半导体芯片制造分为前端工艺、后端工艺。前端工艺就是从单晶硅晶圆,通过数百个、甚至上千个步序,制造成为一个结构化的晶圆(见图10)
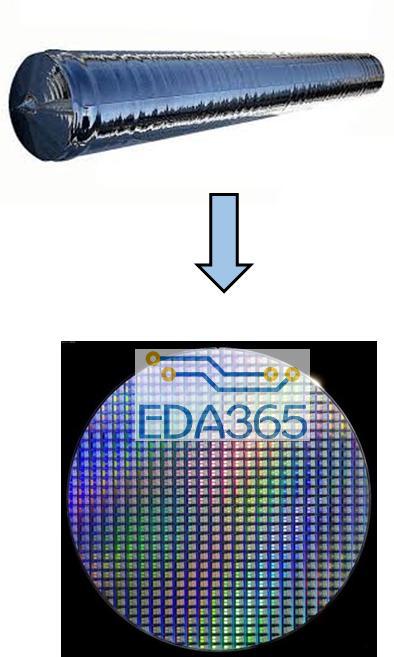
图10 从单晶硅到结构化的晶圆(数百颗半导体芯片(裸片)
一个半导体前端工厂的投资是巨大的,约150 至300亿元(见图11)

图11 一个半导体前端工厂的车间
前端制造工艺主要分为如下几类:
涂层技术 | 化学蒸发 (Chemical Vapour Deposition) |
涂层技术 | 物理蒸发 (Physical Vapour Deposition) |
涂层技术 | 氧化 |
蚀刻技术 | 湿剂 |
蚀刻技术 | 等离子 |
蚀刻技术 | 化学机械抛光 (Chemical Mechanical Polishing) |
光刻 | 光刻 |
嵌入 | 原子嵌入 |
分析 | 视觉分析 |
通常一个半导体物架装有20至30个晶圆,在半导体前端工厂通过数百个工序,时间经历约6至8周,最后生产出结构化的晶圆(裸芯片),其工艺步序如图12示意:

图12 半导体前端工序示意图(英飞凌)
哪么半导体前端工艺的核心是什么呢?
第一,是设备(光刻、蚀刻、涂层、嵌入等),它们就像高精尖物理、化学实验室的仪器。
第二,是这些设备的过程参数,这里包含了许多试验数据、经验值,是核心技术(know-how)。
半导体的后端工艺包括裸片分离、连接(超声波焊接)、封装、测试, 多数工艺都已经标准化了,这里就不细说了。
作者建议:
1.鉴于半导体前端工程投资巨大(150亿 至 300亿),建议相关部门批准数个前端工厂项目,其它半导体企业可以委托这些前端工厂代工,这也是半导体行业比较通行的商业模式,海思、苹果设计芯片,台积电代工。中国一定要有数个自己的、先进的半导体前端工厂!
2.无论是光刻、蚀刻还是涂层、嵌入工艺,这些设备的开发和应用,一定需要国家级科研单位的大力支持(中科院研究所、高校电子学院等),不但要实现设备自给,还要开发出稳定的、芯片完好率高的过程参数,这些才是核心技术!力争突破半导体行业枷锁之二。
总结
1.半导体芯片在未来国民经济中占有举足轻重的位置,无论是5G通讯、城市数字化智能化, 还是交通运输(汽车、铁路、船运、航空)、计算机和软件、化工、装备、物流、航天等行业,都离不开它;
2.中国半导体芯片行业要冲破枷锁,需要集中人才和资源,树立几个自己的芯片设计、芯片制造标杆企业;
3.高端半导体芯片的设计、制造可以用行业通行的外包、代工形式,实现快速、稳健发展;
4.作者预测,在未来15年内,中国将成为全球半导体行业的第一梯队;
5.科学技术是没有国界的,高精尖的学术、技术交流是开放中国的胸怀和远大抱负!
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多