摩尔定律虽命名为“定律”,但究其本质更像是一条预言,一条在过去的50年间始终引导半导体行业发展的伟大预言。但是,现阶段摩尔定律下工艺的无限制成长终会遭遇一道名为“物理极限”的壁垒,如何绕过壁垒以延续乃至超越摩尔定律成为了现如今业界的重要命题。
如果说系统级芯片(SystemonChip,英文简称SoC)技术是摩尔定律不断发展所产生的重要产物,那么系统级封装(SysteminPackage,英文简称SiP)技术便是实现超越摩尔定律的关键路径。在“后摩尔定律”所提供的关键助力之下,SiP生态系统正持续创新以缓解因晶体管尺寸日趋物理极限所产生的压力。
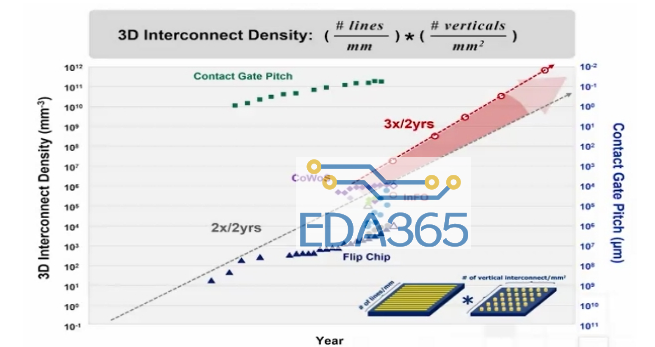
随着5G通信及机器学习技术应用的快速普及,系统级封装SiP技术在短短的时间内便已经成为实现微系统功能多样化、集成异构化、体积及成本最小化的最优方案。

对于SiP技术的生态系统,除了业内人士非常熟悉的半导体材料和计算机辅助设计(CAD)软件之外,IC基板技术及与之关联的供应链同样是SiP生态系统的重要一环。上图所示为当前半导体封测行业中常见的基板技术及其趋势。
目前从技术发展的趋势来看,双面塑模成型技术、电磁干扰屏蔽技术、激光辅助键合技术可以并称为拉动系统级封装技术发展的“三驾创新马车”。
双面塑模成型技术(Double-SidedMoldingTechnology)之所以成为系统级封装工程专家的新宠,主要有两个原因:
(一)有效减少封装体积以节省空间。
(二)有效缩短多个裸芯(BareDies)及被动元件之间的连接线路以降低系统阻抗、提升整体电气性能。
更小的封装体积和更强的电气性能为双面塑模成型技术在SiP领域的广泛应用前景提供了良好的基础。下图所示为一例由长电科技成功导入规模量产的双面塑模成型SiP射频前端模块产品。
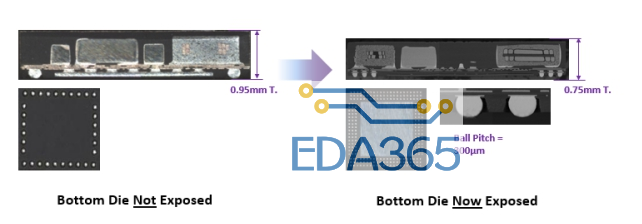
长电科技的双面封装SiP产品采用了多项先进工艺以确保双面塑模成型技术的成功应用。该产品采用了C-mold工艺,实现了芯片底部空间的完整填充,并有效减少了封装后的残留应力,保证了封装的可靠性。
同时Grinding工艺的应用,使封装厚度有了较大范围的选择,同步实现精准控制产品的厚度公差。为了去除流程中残留的多余塑封料,长电科技还采用了LaserablaTIon工艺,以确保产品拥有更好的可焊性。
这项技术看似稀松平常,实则机关暗藏,每一项创新技术的成功落地都要经历许多挑战。双面塑模成型(Double-SidedMoldingTechnology)技术的落地主要面临着以下三大挑战:(一)塑模成型过程中的翘曲问题。
(二)背面精磨(BackGrinding)过程中的管控风险。
(三)激光灼刻(LaserAblaTIng)及锡球成型(SolderBallMaking)中的管控风险。
面对全新工艺所带来的诸多挑战,长电科技选择直面困难,攻克一系列技术难题,并成功于2020年4月通过全球行业领先客户的认证,实现了双面封装SiP产品的量产。
在这项全新突破的工艺中,长电科技严格把控生产流程,采用高度自动化的先进制程,将在双面塑模成型过程可能发生的各类风险隐患进行了有效降低。
由于系统级封装本身制程中大量使用高密度线路、多种材质的封装材料,同时还要考虑芯片与各类功能器件间的协作,且封装结构较为复杂,因此伴随而来的便会有电路元件间产生的电磁干扰问题。长电科技有效的通过创新解决了这一问题,并拥有一系列导入量产的高效电磁干扰屏蔽技术方案。
下图所示为一例由长电科技成功导入规模量产的高效电磁干扰屏蔽SiP射频前端模块产品。
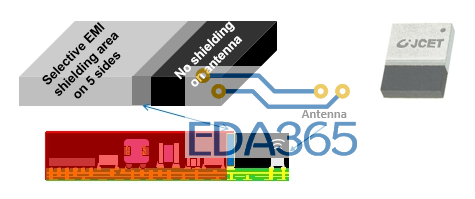
在电磁干扰屏蔽材料(EMIShieldingMaterials)方面,一场技术创新的盛宴正在全球上演。无论是传统材料巨头,还是新晋EMI屏蔽材料先锋,都争相推出质量更可靠、效果更全面、价格更实惠的全新产品及流程方案。
对于绝大多数倒装型(FlipChip)系统级封装产品来说,单芯(PerDie)的平均功率范围一般在1W到15W之间,因此在地散热能力(LocalThermalConducTIvity)是检验SiP系统整体性能的关键一环。
目前可用来提升散热性能的技术方案有以下几种:芯片背面外露技术、高导热塑封材料技术、芯片背面金属板装技术(例如HeatSink)、基板金属内层加厚技术以及芯片背面金属化技术(BacksideMetallizaTIonTechnology)。
长电科技的工程验证结果表明,与其他方案相比,芯片背面金属化技术更适用于加强低、中功率范围的倒装型结构的导热性,同等成本条件下,散热效果的裕值可达到25%,可谓立竿见影。而电磁干扰屏蔽材料的背面金属化技术同样可以用于芯片背面金属化。
如下图所示,长电科技已获得该技术方案的数项发明专利。
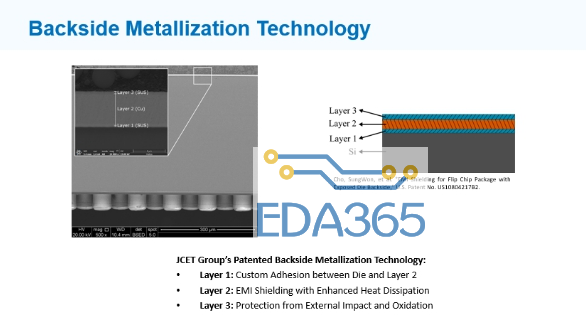
从材料到工艺,从技术到方案,长电科技对于创新的不断追求促成了其在电磁干扰屏蔽技术领域强大的技术实力与全面的产品覆盖。系统级封装(SiP)技术作为目前火热的封装技术领域,在长电科技强大EMI技术的加持之下,能够有效地完成对潜在电磁干扰的屏蔽,满足全球市场需求。
键合(Bonding)可以将两个或多个材料(或结构)结合成为一体,是半导体制造过程中不可缺少的重要环节。纵观近年高端系统级封装产品(尤其是手机射频前端模块)的发展趋势,不难发现,芯片/基板键合(Die-to-SubstrateBonding)技术及其制程创新可谓是居功至伟。
一路走来,从常青树般的回流焊接(MassReflow)技术,到数年前异军突起的热压键合(ThermalCompressionBonding)技术,再到最近才开始发力的激光辅助键合(LAB)技术,先进封测企业与设备方案厂商通力合作,紧跟键合技术潮流,可谓“亦步亦趋,不敢相背”。可以说,越是在先进制程中,我们就越需要超精密的键合技术服务。
下图所示为激光辅助键合(LAB)和回流焊接(MassReflow)技术之间做的一个简单比较。

从图中我们不难看出,回流焊接MR技术容易受到多种限制,包括由于板材变形所引发的Non-wetbump、桥接与ELK层裂纹等引发的封装可靠性问题、模具和基板同时加热时间过长的问题以及老生常谈的CTE不匹配、高翘曲、高热机械应力等问题。而借助激光辅助粘合(LAB)技术,我们便可以轻松解决上述限制。LAB技术借助红外(IR)激光源光束均化器,能够实现高升温速度下的局部加热。
从系统级封装(SiP)技术出发,本文介绍了三驾创新马车双面塑模成型技术、电磁干扰屏蔽技术与激光辅助键合技术在SiP领域的优势。作为全球知名的集成电路封装测试企业,长电科技在系统级封装(SiP)技术领域也为行业带来了更多创新成果。
通过近几年对封装技术的不断探索,长电科技已经成功将芯片背面金属化技术、电磁干扰屏蔽技术、激光辅助键合技术巧妙地整合进了同一套SiP制程里,并通过了量产级别的验证,在散热性能、EMI性能、精密键合性能、制程的稳定性以及整体封装成本等多个指标之间找到并确定了“完美平衡点”。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多