随着目前平面化的芯片开始出现多层式结构,半导体制造的基础将在未来几年发生转变。在全球主要的半导体工程领域花费近十年的时间致力于使得这种结构实现可制造化之后,立体的三维芯片(3D IC)终于可望在明年开始商用化──但这其实也已经远落后于先前规划的时程多年了。
过去几年来,芯片制造商们一直在努力地使与3D IC互连的TSV技术更加完善。现在,TSV已经可针对2D作业实现最佳化了,例如从平面芯片的正面传送数据到背面的微凸块,采用堆栈芯片的3D IC时代即将来临。
去年冬天所举行的国际固态电路会议(ISSCC)上所探讨的主题几乎都是3D芯片,例如三星(Samsung)公司大肆宣传其1Gb行动DRAM,并计划在2013年前量产4Gbit芯片。透过三星的2.5D技术,可使采用TSV的堆栈DRAM与系统级封装(SiP)上的微凸块密切配合。
预计今年秋天就能看到在2.5D技术方面的重大成就──赛灵思(Xilinx)公司将提供一种多级FPGA解决方案,它透过封装技术而使四个平行排列的Virtex-7 FPGA与硅晶内插器上的微凸块实现互连。台湾集成电路制造公司(TSMC)正在制造这种可为FPGA重新分配互连的硅晶内插器──采用一种以‘塌陷高度控制芯片连接’(C4)技术接合基板封装上铜球的TSV技术。台积电承诺可望在明年为其代工客户提供这种突破性的2.5D 至3D过渡技术。
然而,2011年所发布最令人惊喜的3D IC消息来自于IBM公司。该公司最近透露已经秘密地大规模生产可用于大量行动消费电子设备的成熟3D IC,不过使用的仍是低密度的TSV技术。由于累积了相当的技术经验,IBM声称目前已掌握了3D的其它工程障碍,并预计能在2012年时克服这些挑战。
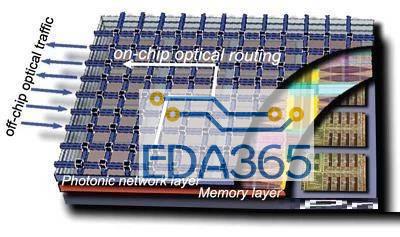
IBM公司展示3D IC未来将如何在相同硅砖上层迭处理器、内存与光学网络等组件
“凭借一招半式闯天涯的时代已经结束了,”IBM公司研究副总裁Bernard Meyerson指出,“如果只想依赖于某种材料、芯片架构、网络、软件或整合,就无法在3D性能战中取得胜算。为了要在3D战场上致胜,就必须尽可能地同时使用所有的资源。”
IBM在今年九月宣布已经与3M公司商讨共同创造一种新的设计材料──这种材料可望解决3D IC最后剩余的工程障碍:过热问题。3M公司的任务在于创造一种适合于堆栈芯片之间的填充材料,也是一种类似电介质的电绝缘体,但比硅晶的导热性更佳。3M承诺可在两年内使这种神奇的材料商用化。
“现在,我们一直在进行试验,希望能在2013年以前发展出一个可行的方案,以实现广泛的商用化,”3M公司电子市场材料部门的技术总监程明说。
然而,对于IBM-3M共同开发的努力能否使双方公司处于3D IC竞赛的领先位置,一些分析师们对此仍存疑。
“3M正在制造一种可为3D堆栈解决散热问题的填充材料,”MEMS Investor Journal先进封装技术的首席分析师Francoise von Trapp说。“虽然这绝对是在3D IC量产前必需解决的挑战之一,但我认为它不见得就是解决3D堆栈其余问题的最后关键。”
3D无处不在
即使IBM公司声称已在3D IC生产方面领先,但市场上也不乏其它竞争厂商。事实上,美国Tezzaron Semiconductor已经为其钨TSV制程提供3D IC设计服务多年了。Tezzaron的FaStack制程可从厚度仅12亳米晶圆的异质芯片中制造出3D芯片。它能以每平方毫米1百万TSV深次微米互连的密度为堆栈DRAM提供Wide I/O。
连续创业的企业家Zvi Or-Bach指出,3D IC设计的焦点必须跳脱TSV至超高密度的单片式3D。Or-Bach会这么说,一点都不令人意外,因为他最近还成为了IP开发公司MonolithIC 3D Inc.的总裁兼CEO。另一家新创的BeSang公司也声称即将制造出不必使用TSV技术的单片式3D内存原型芯片,可望在2012年首次亮相。
然而,当今最先进的技术还是采用TSV的3D芯片堆栈,几乎每一家主要的半导体公司都专注于这项技术的研发。“IBM公司更挑战该技术极限,透过与3M公司的合作以寻求超越当前架构的其它可能性。然而,IBM在3D方面取得的每项进展也将激起像三星(Samsung)、英特尔(Intel)与台积电等竞争厂商的创造力,这些厂商们都已在3D IC方面各自展开相关开发工作,”市场观察公司The Envisioneering Group总监Richard Doherty表示。
用于制造3D IC的技术并不是最近才开发的,而当今的工作重点在进于一步提升这些技术。例如,目前许多 CMOS成像器以TSV将画素数据从基板前面传至背面,而芯片堆栈的概念可追溯到晶体管先驱William Shockley早在1958年时的专利。此后,堆栈芯片的配置常常被加以利用──例如在ASIC上堆栈MEMS传感器,或在处理器核心上堆栈一个小型DRAM--但通常是使用焊线接合的方式来实现互连。
从焊线接合过渡到TSV的方式,使得互连更为密集。它还让设计者们免于严格的矩形布局要求,让他们能像设计电路板一样地进行芯片设计。缺乏电路的地区则可用于其它结构,如垂直互连总线或甚至是制冷剂气体的烟囱等。异质的3D堆栈芯片还提高了整合度,让整个系统可组合成一个单一的硅晶块。
“3D IC最重要的是带来一个摆脱农场般架构的机会,每个芯片分割为毗邻的矩形区域,”Doherty说。“3D芯片设者所使用的方式并不是试图使用芯片上的所有空间,而是开始从芯片上切割出正方形、三角形和圆形以实现垂直互连,并使其得以散热。
“3D技术启发了更多的芯片设计新思维。设计人员们现在能以创新的方式来结合CPU、内存与I/O功能,使他们必须采取不同的思考方式来进行设计。这在过去一切都得并排设计的传统方式是无法实现的。”
全球主要的的半导体组织都为3D技术展开各种标准建立工作。国际半导体设备材料产业协会(SEMI)成立了四个致力于3D IC标准制定的工作小组。此外,其3DS-IC标准委员会包括SEMI会员Globalfoundries、HP、IBM、英特尔、三星与联华电子(UMC),以及Amkor、ASE、欧洲的IMEC、台湾工研院(ITRI)、Olympus、高通(Qualcomm)、Semilab、Tokyo Electron与赛灵思等公司。
半导体制造联盟(Sematech)已经成立了一个3D芯片设计中心。参与成员包括Altera、ADI、LSI、安森美半导体(Semiconductor)和高通等公司。Sematech联盟还在纽约州立大学阿尔巴尼分校科学与工程院设置一条300毫米的3D IC试产线。 [page]
比利时微子研究中心(IMEC)与Cascade Microtech公司合作为3D IC进行测试与特征化。德国研究机构Fraunhofer IZM表示可望在2014年以前将处理器、内存、逻辑、模拟、MEMS和RF芯片整合于单片式3D IC中。
台湾工研院赞助成立了一个3D IC联盟,目前已有超过20家成员联盟。联盟中的许多厂商们均可望从明年初开始提供端至端的3D IC代工服务。
今年九月,在国际半导体展(Semicon)的3D IC技术论坛中,英特尔表示正致力于堆栈3D IC的开发工作(但这并不是指其FinFET三闸晶体管)。此外,在Semicon上,尔必达(Elpida)据称其与力成科技(Powertech Technology)和联电在2Gbit DRAM的共同研发上己取得了进展,该合作团队采用了以高密度TSV连结的堆栈DDR3芯片。
联合电子装置工程协会(JEDEC)可望在今年底前率先为3D IC开发出Wide I/O标准。JEDEC规格将支持512位宽的接口。
法国半导体研究机构CEA-LETI与意法半导体(STMicroelectronics)和硅晶内插器制造商Shinko Electric Industries Co.共同合作,以推动2.5D至3D IC的顺利过渡。该合作小组现于一座300毫米晶圆制造厂生产原型组件,预计最早在2012年推出商用化设计。
欧洲CMOSAIC项目则展开更长程的计划,期望在2013年以前找到冷却单片式3D IC堆栈的创新办法。这项四年期的计划还包括了苏黎世IBM公司、巴黎高等洛桑联邦理工学院(Ecole Polytechnique Federale de Lausanne)以及苏黎世瑞士联邦理工学院(the Swiss Federal Institute of Technology Zurich)等组织的共同参与。
Sidebar:IBM与3M携手抢攻3D IC市场
IBM + 3M = 3D芯片。这已经是一个琅琅上口的公式。“在这项合作计划中,3M公司提供了可实现3D的技术平台,”IBM公司研究副总裁Bernard Meyerson说。
经过多年研究实现3D IC所需的每项组件技术后,IBM确定目前缺少一种非常重要的材料,因而决定与3M公司携手共同创造这种材料。根据IBM表示,影响3D IC发展的关键障碍是一种未填充的材料,它可同时用来作为电绝缘体和热导体,并从热点耗散热。IBM打算使用这种材料来接合3D结构上包含冷却剂的微流体通道。
“3M公司的技术能够满足3D IC接合的真正不同需求,”Meyerson说。 “我们既想要有无限的导热接合剂,也想要电导率为零。”
根据Meyerson表示,最不利的限制是接合剂的热膨胀系数必须与用于互连的金属配合;否则,接合剂加热时将破坏金属化特性。
“热导率、电导率和热膨胀等都是彼此有关的,更遑论其易碎性。这就是我们所谓过度受限的系统。”
3M电子市场材料部技术总监程明说,3M“基本上是一家有能力调合接合剂与聚合物特性的材料公司,甚至能符合相互冲突的规范需求。我们的接合剂将结合不同类型的聚合物、低聚物和单体,以及必备的触角与粘着剂,以满足IBM的规格需求。”
根据3M公司表示,该公司尚未决定这款共同开发的3D IC接合剂是否将会出售给其它芯片制造商。但根据IBM过去的做法,该公司甚至会对竞争对手授权其关键专利。
3M公司也拥有目前机架式计算机用于冷却热点的流体开发经验──那些流体可能会快速地流经微流体通道而进入3D IC中。Meyerson说:“就算你拥有着完美的接合剂,也可能必须排除较高堆栈内层的热量。透过堆栈的微流体信道水冷散热器可以从硅砖中间耗散掉大量的热。”
程明表示:“我们现有的Fluorinert电子氟化液针对数据中心的服务器与硬盘,协助其冷却设备进行散热,但与IBM的合作上,我们还将探索用于协助冷却3D IC的液体。”
除了使制程技术更加精炼,以实现堆栈芯片的互连与维持冷却状态外,设计人员们还必须思考可能从3D IC串流而出的数据量。在这方面,光子将成为3D IC处理大量I/O时不可分割的一部份。
“目前的电子数据传输可能消耗高达50%的芯片功率。而光子在每位瓦数方面具备更高能效,将成为3D IC的基本要素。”Meyerson指出,“在堆栈3D IC时,我们将会需要用到激光器、谐调器和侦测器。”
虽然3M与IBM合作的消息不久前才对外发布,但3M公司开发3D解决方案其实已经有一段时间了。事实上,今年稍早,3M公司就曾经发布一款用于处理3D堆栈晶圆的技术。该公司这款芯片承载系统(Wafer Support System;WSS)简化专为堆栈而磨薄晶圆的处理过程。
WSS系统“首先以临时黏着剂将磨薄的晶圆黏在玻璃上,使玻璃在接合过程中可支撑晶圆,”程明解释,“接着,在两块晶圆堆栈后,再透过雷射剥离过程移除用于承载的玻璃。”
预计在2013年以前,3M公司和IBM公司可望准备好这款端对端制程方案,为有如硅晶摩天大楼般堆栈高达100层芯片的处理器、内存、混合讯号、连网与I/O等异质性芯片堆栈实现广泛的商用化量产。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多