封装技术趋势将有变化。在封装技术的三大关键词“高密度”、“高速及高频率”和“低成本”中,“高密度”的实现日趋困难。如在日本电子信息技术产业协会(JEITA)2009年6月发表的“日本封装技术发展蓝图”2009年度版中,要求半导体封装的最小间距在2012年达到0.3mm之后,直到预测截止时间2018年都将停留于此(图1)。而在2007年度版中,则有2010年达到0.4mm,2016年达到0.2mm的渐次间距微细化要求注1)。
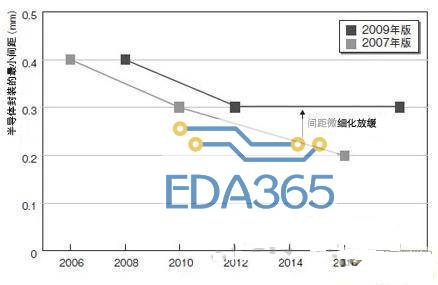
图1 封装技术的间距微细化困难
2012年达到0.3mm,直到预测截止时间2018年都将停留于此。《日经微器件》根据“日本封装技术发展蓝图”2007年度版和2009年度版制作。
注1)对发展蓝图实施的问卷调查结果显示,“间距0.15mm的要求曾出现在2007年度版中,但未出现在2009年度版中”(JEITA Jisso战略专门委员会/封装技术发展蓝图组机器组装工作组主管间仁田祥)。另外,有人指出没有了对“0201”部件的要求,采用“0402”部件的 “价值不如从前”、“采用情况不明”。
但是,今后即使继续提高密度,也无法同时满足要求高速性的高频化和低成本化。原因有两方面。一是市场上对成本降至更低和支持高频率的要求更强烈。二是印刷底板技术已经饱和。印刷底板技术方面,为减小间距的各单项技术已经问世。但是,“组合这些技术,还是无法满足用户——组装厂商所期待的高频率和成本” (便携产品厂商的封装技术人员)。
由于机器要配备通信功能,因此对主板支持高频率的要求越来越强烈。比如,数码相机已采用USB2.0及HDMI(高清多媒体接口)等高速差动信号,今后频率仍将不断提高。因此,封装密度越来越难以提高。具体而言,数码相机厂商要求主板的相对介电常数到2012年降至3,到2018年降至2,达到与现在高端计算机相当的水平(图2)。

图2:各种电子产品的介电常数不断降低随着产品性能的提高和通信功能的配备,要求主板不断降低介电常数。《日经微器件》根据“日本封装技术发展蓝图”2009年度版制成。
台式电子产品也要求降低介电常数。原因是随着通信功能的配备和性能的提高,处理器与存储器之间的接口将日益高速化。并且,在台式机与便携产品工作频率相同的情况下,台式机的主板更需要降低介电常数。原因是底板面积大导致传输线路延长,信号衰减会更加严重。因此,数字电视对主板相对介电常数的要求是 2012年降至3.6~4.3,与现在中档网络产品相当。
对于这些产品,过去曾强烈要求降低成本。以前一直能够兼顾低成本和高密度,但由于今后必须支持高频率,所以提高密度的要求退居其次。因此,数码相机主板封装间距的微细化程度只达到0.4mm。
为了实现高频化及高密度化,功能模块及副板在推进采用部件内置底板的进程。数码相机及类似“iPod”的个人AV产品厂商为实现通信功能在积极推动采用功能模块。另外,在数码相机等产品方面,除了通信功能之外,数字调谐器也在向功能模块化发展。[page]
在部件内置底板中,目前采用趋于增多的是配备已封装好的LSI及芯片型无源部件的类型。比如,部件内置底板厂商大日本印刷(DNP)的量产供货量于 2008年11月累积达到了1亿个(图3)。使用裸片的类型以及在底板形成工序中嵌入无源部件型的内置底板,目前成品率较低,因而成本过高,大多不符合组装厂商的要求。
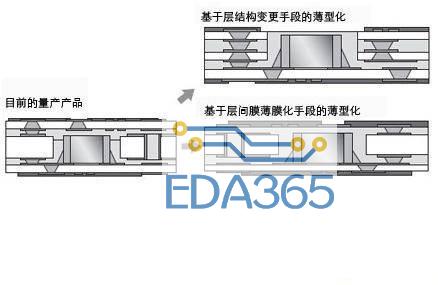
图3:DNP将部件内置底板“B2it”薄型化
为实现薄型化,结合使用了层结构上下非对称化、层间绝缘膜薄膜化及内置部件扁平化三种手段。该图由《日经微器件》根据大日本印刷(DNP)的数据制成。
今后的目标是实现组装厂商要求的高密度化。比如在手机领域,为了将RF(Radio Frequency)模块等减小至10mm见方左右,组装厂商要求20μm的微细间距和厚度为0.2mm的薄型化。为了达到这一目标,首先将推进配备已封装好的LSI及芯片型部件的部件内置底板向微细间距化及薄型化发展。之后,在该类型的底板到了难以高密度化的阶段时,会有向配备裸片及嵌入无源部件的部件内置底板过渡的可能。目前,部件内置底板厂商松下电子元器件及大日本印刷(DNP)等正在朝着这一方向推进以高密化为目标的技术开发。
在主板技术中,材料的变化出现新趋势,能够在适应高频率的同时实现低成本化的底板材料纷纷亮相。
松下电工上市了印刷底板材料“MEGTRON4”,与高端服务器等使用的以往产品相比,降低了高频适应能力,从而实现了低成本化(图4)。 “MEGTRON4”将介电常数控制在3.8,将介质损耗角正切控制在0.006,增加了低价常用材料的比例。通过降低材料费并提高成品率,实现了介于该公司高性能底板材料与普通底板材料之间的定价。

图4:“MEGTRON4”的电气特性和耐热性 “MEGTRON4”的电气特性和耐热性均介于高性能底板材料“MEGTRON6”与普及底板材料FR-4之间。本图由《日经微器件》根据松下电工的数据制成。
松下电工将该材料定位于中端网络设备使用的产品,介电常数及介质损耗角正切与今后各种电子设备的要求值相符合。如果通过量产进一步降低成本的话,便有望将应用范围扩大至网络设备以外的领域注2)。
注2)松下电工已推出使用PPE(聚苯醚)树脂,1GHz下介电常数仅为3.5,介质损耗角正切仅为0.002的“MEGTRON6”。估计MEGTRON4通过降低性能,减少了价格昂贵的PPE的比例。
日立化成工业也在JPCA Show 2009上参考展出了1GHz下介电常数为3.4~3.6,介质损耗角正切为0.003~0.004的底板材料“MCL-FX-35”。可支持配备有GHz频带通信功能的产品。
在提高主板设计技术方面,凸版NEC电路解决方案等提出了可通过将主板与半导体封装等一体化来进行优化的综合设计解决方案。半导体封装与底板作为整体来降低放射噪声及电源噪声,由此实现信号波形的优化。这样便可在进行高密度化及低成本化的同时,实现对高频率的适应性。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多