虽然电子器件带来的功能似乎没有止境,但是数字和模拟器件的集成器件制造商(IDM)仍然不得不在所用材料的物理限制内设计解决方案。由于半导体发展大趋势和终端市场带来的需求,随着时间推移,管理产品的热密度变得越来越重要。
一般而言,热管理管理的是二极管和晶体管的半导体结产生的热量。在高度集成的数字器件中,每两年,晶体管数量大约就会翻一番,而成本保持不变,这符合摩尔定律。功率密度是促使集成器件制造商开发高度集成的数字器件的主要推动力,而众所周知,它长期以来一直是一个限制因素。
问题在于,随着体积缩小,芯片设计师可以将更多器件放入给定面积中,或者使用相同数量的器件但让晶粒体积更小。集成器件制造商承受着以相同(或更低)价格提供更多功能的市场压力,而不是以更低价格提供相同功能的压力,这意味着它们倾向于添加更多晶体管,而不是降低晶粒体积和成本。这是因为,相对而言,硅较便宜。
对于主要生产模拟器件,尤其是功率晶体管的制造商而言,器件内的栅极/晶体管数量远不那么重要。重要的因素是在给定晶粒体积中器件能够处理的功率量。虽然人们通常认为“越小越好”,但是在集成功率器件方面,晶粒体积主要由额定功率决定,因此晶粒体积降低存在实际限制。
挑战这一限制可能导致可靠性降低,这是由功率开关器件周期的不利影响造成的。位于这个问题中心的就是半导体结(从位置上看,也位于中心)的温度。
芯片级的热阻
充分利用功率器件的性能意味着要确保器件处于安全运行范围内,而这一要求可以改写为将结温保持在175°C以下。满足上述要求的关键在于了解运行时结生成的热量在散热时经过的路径。
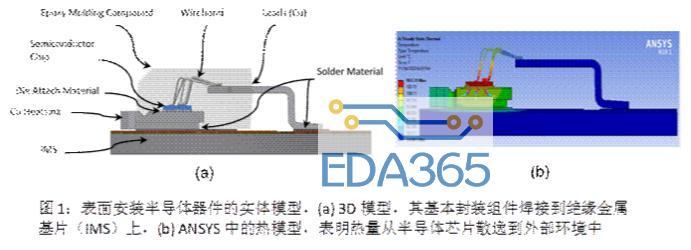
在计算散热路径的总热阻时,必须考虑路径中每种材料各自的热阻。一般而言,集成器件制造商在设计器件时,会得到可预测、可再现的结壳热阻,即RθJC。通常,此数值包含半导体基片的热阻、将晶粒连接到封装的材料的热阻以及制造封装的材料的热阻。在采用硅基片的功率器件中,晶粒通常通过焊接方式连接到封装上,而封装(壳)的主要成分很可能是铜,从而得到了RθJC值。
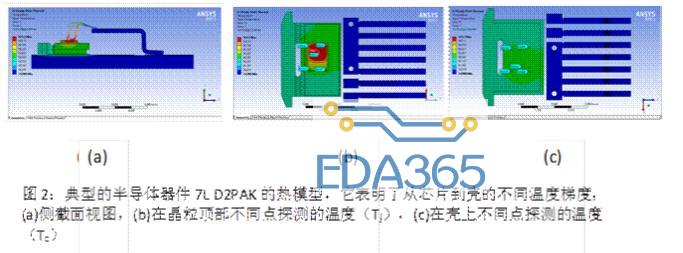
表1:材料属性表和根据图2计算得到的RθJC

晶粒的体积会直接影响结产生的热量和所需的散热速度。从这方面看,体积越大越好。晶粒越大,热量在离开结时可经过的表面积就越大。然而,推动数字器件的集成器件制造商发展的市场力量也存在于模拟和功率半导体领域,工程师想要更小的晶粒,因为这意味着性能更高,成本更低。
什么是银烧结?
在经过结和晶粒后,热量散逸时遇到的下一个热屏障是晶粒与封装的连接点。行业标准做法是在接触点进行焊接。大部分情况下,焊接都是一个好办法。它易于采用,较为便宜且较为可靠。该连接处的导热系数需要考虑材料的量,而不仅仅是厚度,而且不同材料会有不同厚度。材料量将主导该连接处的导热系数,因为热量会朝着所有方向散逸,但是根据遇到的热阻,散热速度会有所不同。铅合金焊接方法的一个替代方案是使用能够烧结的焊膏。焊膏材料的导热系数往往高得多,而且常常可以用于更薄的层。银是很好的示例,银烧结层的导热系数可以达到1.4-2 W/cm/°C左右。与导热系数仅为0.25 W/cm/°C的铅焊相比,银烧结更好。

器件制造商为什么采用银烧结技术
在功率器件中,流经焊接处的热量非常高,因此需要更加注意晶粒与框架连接处的热性能及其处理高温而不降低性能的能力。烧结银的热阻要比焊料低得多,因而使用烧结银代替焊料能提高RθJC,而且由于银的熔点较高,整个设计的热裕度也提高了。
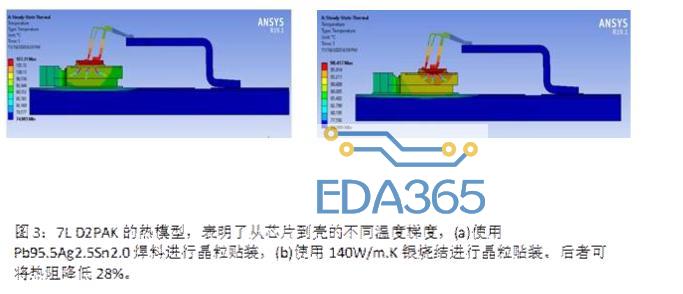
工程师通常不会考虑让功率半导体内置更高的热裕度,主要原因是一直到最近,他们才能选择基于烧结银的器件设计。既然这些器件已经出现在市场上了,工程师们就可以针对如何解决热管理问题制定更明智的决策了。
如上文所述,向着更小晶粒面积发展的趋势能带来性能和成本方面的优势,也会带来散热方面的劣势。选择采用碳化硅(SiC)作为半导体基片的器件意味着这些优势仍会存在,而劣势则会削弱。这是半导体行业及其支持的所有垂直市场会对基于SiC的功率半导体如此感兴趣的主要原因之一。
SiC基片比硅基片更小更薄。将SiC基片与烧结银(作为基片与框架的连接处)结合使用时,得到的RθJC值与其他功率半导体相当,但是却能拥有SiC基片的优势。这些优势包括更高的开关速度和更高的效率,从而带来更高的热密度,进而得到更小的最终产品。
并非所有集成器件制造商都需要使用烧结银
由于烧结银具有明显优势,似乎有理由期盼所有集成器件制造商都使用烧结银。制造商不使用,至少现在不使用烧结银的主要原因是IGBT等基于硅的功率器件需要具有不小的晶粒面积,因此晶粒和引脚框架之间自然有非常好的导热系数。在这种情况下使用烧结银能带来的回报较小。事实上,正如之前提到的,壳与周围之间的热阻RθJA很大程度上是由电路板和系统设计决定的,因此不受集成器件制造商控制,它通常比结壳之间的热阻RθJC大得多。这点不仅对功率器件成立,对所有半导体皆成立。
在功率半导体的晶粒面积相当小(这是SiC器件的常规特性)的情况下,较小的晶粒体积能有效促使采用银烧结技术代替铅基焊料。烧结银带来的较高导热系数能确保器件仍在安全运行范围内运行,同时将结温维持在最高运行温度以下,即使在从晶粒开始的散热路径变小很多的情况下也是如此。
工程师喜爱烧结银的原因
大部分情况下,硅基功率半导体的制造商都不太可能使用烧结银代替焊料。不过,虽然烧结银能给SiC器件带来优势很大程度上是因为SiC器件的较高性能和较小晶粒体积,但是通常,它确实能带来显著的工程优势。系统工程师可以采用以下方式利用这些优势。
首先,采用熔点更高的连接点可为设计带来更高的热裕度。随着结的热量增加,且硅器件/基于焊料器件中的热路径的限制效果变得更明显,焊料的温度有可能会接近焊料的熔点。这不会导致突然故障,但是重复的功率周期可能会使连接处的性能下降,这意味着该处最终会压力过大,并成为一个弱点。
情况也许比想象中乐观,烧结银的采用实际上可以带来更大的系统增益。如上所述,在计算总热阻时,结与周围之间的热阻RθJA是典型的主要影响值。然而,不断发展的更精细和高效的冷却解决方案,如高性能应用中的液冷,使得主要影响因素变为RθJC。
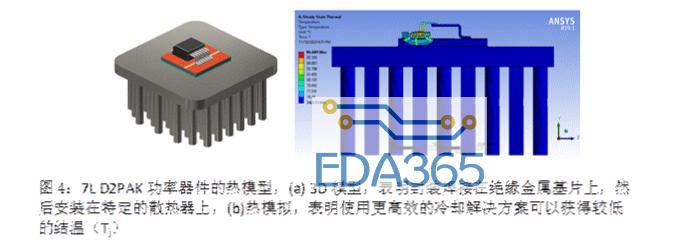
这些高性能的热管理系统非常昂贵,但是在某些应用中十分必要。如果功率半导体成为实际上的限制性因素,就很可能无法实现上述系统的低成本和复杂性,当然,如果在系统层面更高效地处理热量,则可以实现。
因而,可以实现此处所述的低结壳热阻的功率开关器件能更好地支持这些高性能应用。
结语
工程领域的许多人都不了解半导体器件设计和制造的细节,而且确实没有必要深入了解每个集成器件工程师在产品设计中运用的物理细节。不过,偶尔,探索细节也是合理的。
银烧结就是这种情况。在功率半导体中,尤其是在基于碳化硅等宽带隙材料的功率半导体中,采用银烧结会直接影响这些器件能带给最终应用的实际价值。
虽然大部分功率半导体目前不采用银烧结技术,但是UnitedSiC预计这种情况会发生变化。由于它为组件级和系统集成方面带来的优势,采用银烧结正在成为所有产品的标准做法。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多









