IEEE EDM技术会议上,Intel展示了两种新型封装设计,一个是ODI,一个是3D Foveros,之前我们都做过详细介绍。封装如今已经是Intel的技术支柱之一,和制程工艺并列。
Foveros 3D立体封装技术是在今年初的CES大会上宣布的,可以将多个硅片堆叠在一起,缩小整体面积,但提高内部互连通信效率,并且可以灵活控制不同模块,满足不同需求,还可以采用不同工艺。
首款产品代号Lakefiled,就在内部集成了10nm工艺的计算Die、14nm工艺的基础Die两个硅片,前者包含一个高性能的Sunny Cove/Ice Lake CPU核心、四个高能效的Tremont CPU核心,整体尺寸仅为12×12毫米。
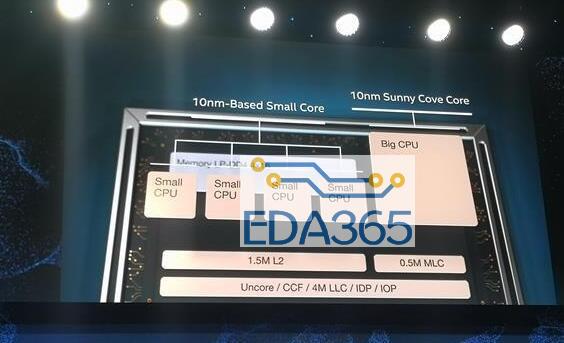
微软双屏Surface Neo、三星笔记本Galaxy Book S都已经宣布采纳Lakefiled,但最快也要到明年年中才会上市。
另外,Intel全新的Xe HPC高性能计算卡的首款产品Ponte Vecchio也会使用Foveros封装,将八个计算硅片整合在一起,但要到2021年晚些时候才会登场。
本次会议期间,Intel首席工程师透露,2020年底的时候,Lakefield就像迎来升级,并且很快就会出现在市面上。
可惜详情欠奉,不知道会怎么升级,可能会加入新的计算和IO单元,可能会更平衡地调整不同模块的配合,可能支持PCIe 4.0等新技术。
有趣的是,Intel提到了Foveros立体封装技术也可以包括基带在内,而在不久前,Intel刚刚宣布与联发科合作,在未来的笔记本中加入后者的5G基带,打造5G PC。
难道,Intel未来会把第三方5G基带集成在自家处理器中?
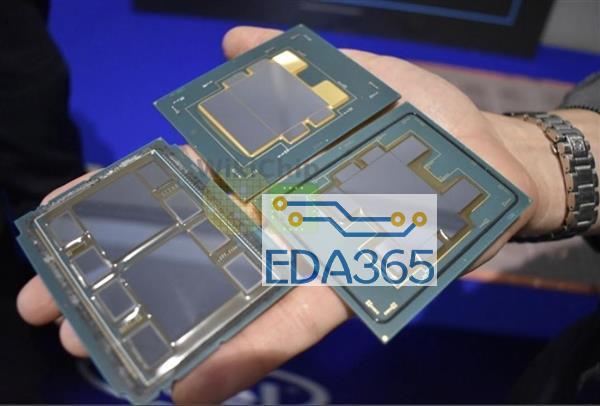


 APP下载
APP下载 登录
登录















 热门文章
热门文章








