近年来,移动通信和移动计算领域的便携式电子机器市场火爆,直接推动了小型封装和高密度组装技术的发展;同时,也对小型封装技术提出一系列严格的要求,诸如,要求封装外形尺寸尽量缩小(尤其是封装高度小于 1mm),封装后的连接可靠性尽可能提高,适应无铅化焊接(保护环境)和力图降低成本。如今的便携式电子机器对器件封装要求果真这样严格吗?其实,说不定你手里的第三代蜂窝电话手机已用到甚薄型 QFN 封装结构。这种手机上的显示板采用电源 LSI 和数码相机里电动机驱动用智能化功率LSI电路等的封装,要求确实十分严格。幸好,这些电路器件使用的引出线并不多,否则几乎难以实现
QFN(Quad Flat No-leadPackage,方形扁平无引脚封装),表面贴装型封装之一。现在多称为LCC。QFN 是日本电子机械工业 会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度 比QFP 低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电 极触点 难于作到QFP 的引脚那样多,一般从14 到100 左右。 材料有陶瓷和塑料两种。当有LCC 标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。塑料QFN 是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm 外, 还有0.65mm 和0.5mm 两种。这种封装也称为塑料LCC、PCLC、P-LCC 等。
小型化封装结构现已有很多种,如球栅阵列 BGB 封装等,但是,其内部的布线基板成本高,远不如 QFP 可实现低成本化。然而,现行的 QFP 结构内部引出的引线呈羽翼状扇出,占用较大装配面积(手机内装配面积十分有限),不能满足要求。2000年JEDEC制定出一种改进型规格,叫作QFN(Quad Flat NonLeaded Package)。顾名思义,QFN 把QFP 扇出的引出线折回到封装底部(变成条状接触线),故可节省装配面积,进一步实现小型化。
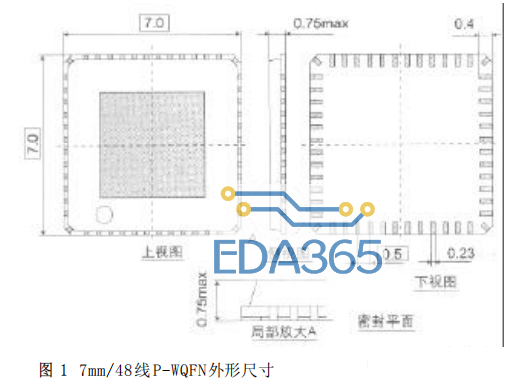
NEC 公司半导体事业部的技术人员根据QFN标准规格,开发出塑料(plastic)的 QFN 结构,其厚度甚薄(very verythin=W)、简称 P-WQFN 封装结构。该封装结的投影图如图1所示,其外观如照片所示,P-WQFN 封装系列详见表 1。
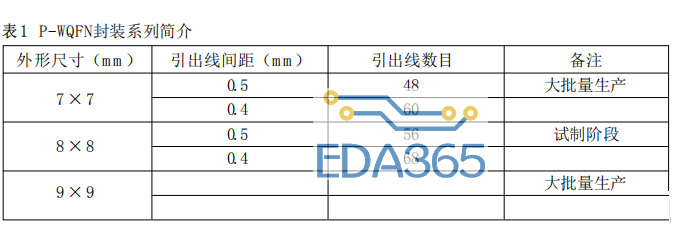
从图 2 所示的 P-WQFN 封装的断面结构图中可以了解其制造工艺的概况,它是模铸树脂把已压焊好引线的芯片浇铸在树脂里固定,由底部露出的电路引出线里的表面底部(焊盘)上有金属镀层,便于回流焊接。因为要求实现无铅焊接,故引出线露出部分的镀层不是利用 SnPb 合金而是 Sn-Bi 合金。

首先,P-WQFN 封装在组装过程中表现出良好的耐热性能。因为,在原材料和结构的选择阶段就充分考虑到可耐受260℃(最高)回流焊的高温工艺流程、P-WQFN 封装在整机装配时能顺利地通过260℃的回流焊接过程(回流焊接规程中规定260℃高温加工时间不大于10秒,220℃高温处理时间不超过60秒)。特别应当指出,P-WQFN 封装之所以能表现出良好的耐热性能,关键在于设计时已选定IC芯片和引线框之间粘合用的特殊耐高温树脂和引线框基盘裸露在粘合用塑料的表面之上,从而防止形变产生断裂(可防止在高温回流焊时因热应力而断裂与剥离)。另外,PWQFN 底面上露出的引线焊盘表面有 SnBi镀层,它和回流焊用的焊料(Sn-3Ag-0.5Cu)能在回流焊过程中实现牢固焊接。
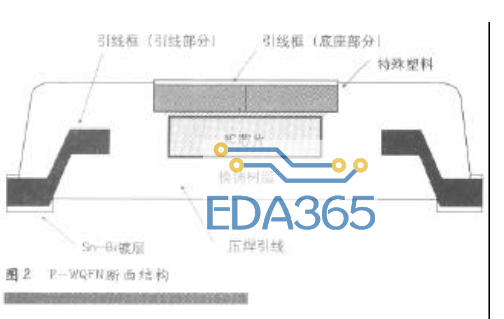
其次,P-WQFN 封装在整机装配(手机、数码相机等)后,表现出很好的可靠性。为证实这一点,在商品化之前可根据手机和数码相机等装配应用进行一系列的可靠性测试。例如,9mm/64线P-WQFN封装即将商品化,它已经成功地通过可靠性测试。其可靠性测试内容包括很多项,诸如度循环、弯曲和加压等;若一定量样品在可靠性测试中无一损坏,即可通过可靠性测试关卡。例如,对5 个9mm/64线P-WQFN封装进行跌落测试,从100cm高度自由落下(包括 P-WQFN 的 X、Y 和Z各面分别着地两次,均未发现损坏;其它各项测试结果也都无损坏。9mm/64线P-WQFN 封装商品化在即,7mm/48 线PWQFN 早已实现商品化。
P-WQFN封装是定位于手机和数码相机等便携机器市场的封装产品,由于它能满足这一应用领域的严格要求,今后必将取代这一领域的QFP/SOP 等陈旧式封装。特别是适用于无铅焊接口艺,符合环境保护要求。
『本文转载自网络,版权归原作者所有,如有侵权请联系删除』
 热门文章
更多
热门文章
更多